IGBT模塊工作原理以及檢測方法
IGBT模塊簡介
IGBT是Insulated?Gate?Bipolar?Transistor(絕緣柵雙極型晶體管)的縮寫�,IGBT是由MOSFET和雙極型晶體管復(fù)合而成的一種器件���,其輸入極為MOSFET���,輸出極為PNP晶體管��,它融和了這兩種器件的優(yōu)點��,既具有MOSFET器件驅(qū)動功率小和開關(guān)速度快的優(yōu)點,又具有雙極型器件飽和壓降低而容量大的優(yōu)點,其頻率特性介于MOSFET與功率晶體管之間���,可正常工作于幾十kHz頻率范圍內(nèi)�,在現(xiàn)代電力電子技術(shù)中得到了越來越廣泛的應(yīng)用��,在較高頻率的大����、率應(yīng)用中占據(jù)了主導(dǎo)地位。
可知,若在IGBT的柵極G和發(fā)射極E之間加上驅(qū)動正電壓,則MOSFET導(dǎo)通��,這樣PNP晶體管的集電極C與基極之間成低阻狀態(tài)而使得晶體管導(dǎo)通�����;若IGBT的柵極和發(fā)射極之間電壓為0V���,則MOS?截止����,切斷PNP晶體管基極電流的供給��,使得晶體管截止���。IGBT與MOSFET一樣也是電壓控制型器件����,在它的柵極G—發(fā)射極E間施加十幾V的直流電壓����,只有在uA級的漏電流流過,基本上不消耗功率��。
2?IGBT模塊的選擇 IGBT模塊的電壓規(guī)格與所使用裝置的輸入電源即試電電源電壓緊密相關(guān)�。其相互關(guān)系見下表。使用中當(dāng)IGBT模塊集電極電流增大時����,所產(chǎn)生的額定損耗亦變大�。同時����,開關(guān)損耗增大,使原件發(fā)熱加劇���,因此�����,選用IGBT模塊時額定電流應(yīng)大于負(fù)載電流��。特別是用作高頻開關(guān)時�����,由于開關(guān)損耗增大����,發(fā)熱加劇����,選用時應(yīng)該降溫等使用。?3?使用中的注意事項 由于IGBT模塊為MOSFET結(jié)構(gòu)����,IGBT的柵極通過一層氧化膜與發(fā)射極實現(xiàn)電隔離。由于此氧化膜很薄�����,其擊穿電壓一般達(dá)到20~30V�����。因此因靜電而導(dǎo)致柵極擊穿是IGBT失效的常見原因之一��。因此使用中要注意以下幾點:
?
1. ?在使用模塊時�,盡量不要用手觸摸驅(qū)動端子部分����,當(dāng)必須要觸摸模塊端子時,要先 將人體或衣服上的靜電用大電阻接地進(jìn)行放電后,再觸摸���;
2. ?在用導(dǎo)電材料連接模塊驅(qū)動端子時��,在配線未接好之前請先不要接上模塊��;
3. ?盡量在底板良好接地的情況下操作���。
在應(yīng)用中有時雖然保證了柵極驅(qū)動電壓沒有超過柵極最大額定電壓,但柵極連線的寄生電感和柵極與集電極間的電容耦合,也會產(chǎn)生使氧化層損壞的振蕩電壓�����。為此�����,通常采用雙絞線來傳送驅(qū)動信號,以減少寄生電感��。在柵極連線中串聯(lián)小電阻也可以抑制振蕩電壓�。 此外,在柵極—發(fā)射極間開路時�����,若在集電極與發(fā)射極間加上電壓�����,則隨著集電極電位的變化�,由于集電極有漏電流流過,柵極電位升高�����,集電極則有電流流過����。這時,如果集電極與發(fā)射極間存在高電壓,則有可能使IGBT發(fā)熱及至損壞。
在使用IGBT的場合��,當(dāng)柵極回路不正?�;驏艠O回路損壞時(柵極處于開路狀態(tài))��,若在主回路上加上電壓��,則IGBT就會損壞,為防止此類故障,應(yīng)在柵極與發(fā)射極之間串接一只10KΩ左右的電阻�。
在安裝或更換IGBT模塊時���,應(yīng)十分重視IGBT模塊與散熱片的接觸面狀態(tài)和擰緊程度����。為了減少接觸熱阻�����,最好在散熱器與IGBT模塊間涂抹導(dǎo)熱硅脂����。一般散熱片底部安裝有散熱風(fēng)扇����,當(dāng)散熱風(fēng)扇損壞中散熱片散熱不良時將導(dǎo)致IGBT模塊發(fā)熱,而發(fā)生故障��。因此對散熱風(fēng)扇應(yīng)定期進(jìn)行檢查����,一般在散熱片上靠近IGBT模塊的地方安裝有溫度感應(yīng)器,當(dāng)溫度過高時將報警或停止IGBT模塊工作����。?
4?保管時的注意事項?
1. ?一般保存IGBT模塊的場所��,應(yīng)保持常溫常濕狀態(tài),不應(yīng)偏離太大�����。常溫的規(guī)定為 5~35?�,常濕的規(guī)定在45~75%左右。在冬天特別干燥的地區(qū)���,需用加濕機(jī)加濕;?
2. ?盡量遠(yuǎn)離有腐蝕性氣體或灰塵較多的場合�����;
3. ?在溫度發(fā)生急劇變化的場所IGBT模塊表面可能有結(jié)露水的現(xiàn)象����,因此IGBT模塊應(yīng) 放在溫度變化較小的地方����;
4. ?保管時,須注意不要在IGBT模塊上堆放重物; 5.?裝IGBT模塊的容器,應(yīng)選用不帶靜電的容器�。
二.IGBT模塊得測試簡介
根據(jù)測試條件和測試線路的不同��,可將IGBT模塊的測試分為兩大類:一類是靜態(tài)參數(shù)測試,即在IGBT模塊結(jié)溫為25時進(jìn)行測試,此時IGBT工作在非開關(guān)狀態(tài)�����;另一類是動態(tài)參數(shù)測試�,即在IGBT模塊結(jié)溫為125時進(jìn)行測試�,此時IGBT工作在開關(guān)狀態(tài)�。
1. 靜態(tài)參數(shù)測試
(1)柵-射極最大漏電流IGES測試 ,該項測試在額定的G-E極電壓下進(jìn)行�����。測試時必須將G-E極短路����。其測試原理如圖1a所示�。通常情況下,Vdrive=±20V����。此時IGES(+)<100nA,而IGES(-)>-100nA.
(2)柵極閾值電壓VCE(th)測試在該項測試中,須將G-E極短路��,測試原理如圖1b所示�����。從集電極注入一恒定的電流�,此時因IGBT處于關(guān)斷狀態(tài),故不會有電流從C-E結(jié)間流過���。G-E極間固有的電容開始充電,當(dāng)G-E結(jié)上電壓達(dá)到VGE(th)時�����,IGBT開始導(dǎo)通��。此時���,將有電流從C-E結(jié)流過����,通過監(jiān)控該電流就能達(dá)到測試VGE(th)的目的���。
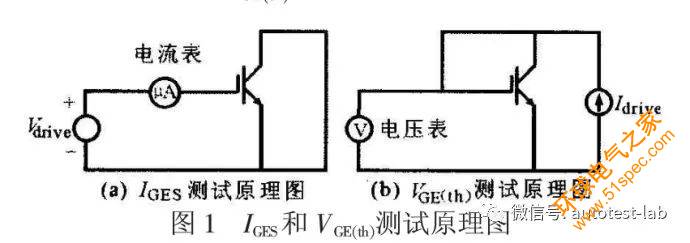
VGE(th)呈負(fù)溫度系數(shù)特性��,經(jīng)過測試���,其溫度系數(shù)為:-11mV/�。例如��,在25時����,VGE(th)=3V,到150時���,VGE(th)只有1.63V�����。
(3)C-E極通態(tài)壓降VCE(on)測試即指在額定集電極電流Ie和額定G-E極電極VGE下的G-E極通態(tài)壓降。該參數(shù)是IGBT營業(yè)中的重要參數(shù)��,其大小直接決定通態(tài)損耗的大小��。測試原理圖見圖2a����。
(4)續(xù)流二極管的正向壓降VEM測試即指IGBT模塊中與IGBT芯片反并的續(xù)流二極管的正向壓降�。該值與IGBT模塊的關(guān)斷特性緊密相關(guān),若VEM小�,則IGBT關(guān)斷速度快�����,關(guān)斷損耗會減小,但是關(guān)斷時IGBT上的過沖電壓尖峰較高��;反之����,則會造成關(guān)斷損耗增大��。其測試原理如圖2b所示��。

(5)C-E極漏電流ICES測試進(jìn)行該項測試時,G-E極應(yīng)短路�,在C-E極上加IGBT的額定電壓Ve set.測試原理圖見圖3a�����。
(6)G-E極阻斷電壓VCES(Bias)測試進(jìn)行該項測試時����,柵極和發(fā)射極應(yīng)短路。在指定的集電極電流值ICset下�,集-射極上的最小電壓即為VCES(Bias)�����。通常情況下,Ie set=1mA.測試電路見圖3b����。
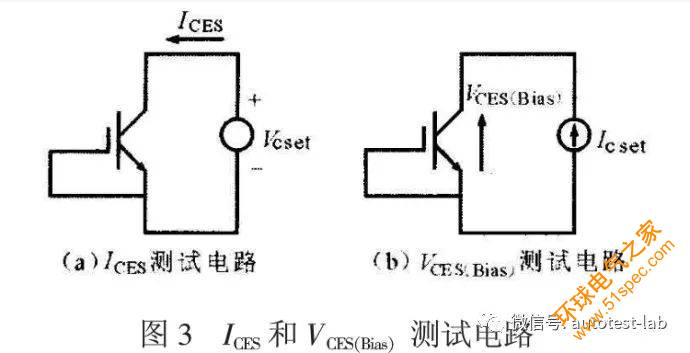
IGBT的阻斷電壓隨結(jié)溫的上升而上升���。對于額定電壓為600V的IGBT�����,其VCES(Bias)通常為25時的阻斷電壓����,因為它隨溫度下降而降低��,所以在-40時�����,額定電壓600V的IGBT模塊,其VCES(Bias)≈550V����。
2. 動態(tài)參數(shù)測試
(1)擎住電流LUT測試IGBT的縱向結(jié)構(gòu)為pnpn4層結(jié)構(gòu),如果條件合適,踏能像晶閘管一樣擎住,此時IGBT的負(fù)載為阻性負(fù)載���。通常情況下,集電極電壓VCC為額定電壓60%擎住電流為額定電流的兩倍。LUT測試的時序如圖4所示。通常測試系統(tǒng)的電流保護(hù)值Iprot設(shè)定為額定電流的3.5~4倍。

(2)能耗Eloss測試對于電路設(shè)計者來說�,開關(guān)過程中元件內(nèi)部的能量損耗非常重要�,藉此可以計算出開關(guān)損耗的平均值�����。進(jìn)行此項測試時�,IGBT的負(fù)載為感性負(fù)載����。總的開關(guān)損耗值由兩部分組成:開通損耗Eon,其中包括與IGBT芯片反并續(xù)流二極管的反向恢復(fù)損耗;關(guān)斷損耗Eoff,包括電流拖尾部分的損耗。IGBT開關(guān)損耗波形如圖5所示���。

(3)反偏安全工作區(qū)(RBSOA)測試該項測試主要用于考核IGBT模塊關(guān)斷時工作在最大電流和電壓下的工作能力。此時,IGBT的負(fù)載為感性負(fù)載����,其測試原理圖和參考波形如圖6a所示����。
(4)短路(SHORT CIRCUIT)測試該項測試是在一定的VCC下檢測IGBT模塊直接對電源短路的有限時間��,借此考核IGBT承受電流郭沖的能力���。其測試原理圖和參考波形如圖6b所示���。